集成電路
一種微型電子器件或部件
集成電路(integrated circuit)是一種微型電子器件或部件。採用一定的工藝,把一個電路中所需的晶體管、電阻、電容和電感等元件及布線互連一起,製作在一小塊或幾小塊半導體晶片或介質基片上,然後封裝在一個管殼內,成為具有所需電路功能的微型結構;其中所有元件在結構上已組成一個整體,使電子元件向著微小型化、低功耗、智能化和高可靠性方面邁進了一大步。它在電路中用字母“IC”表示。集成電路發明者為傑克·基爾比(基於鍺(Ge)的集成電路)和羅伯特·諾伊思(基於硅(Si)的集成電路)。當今半導體工業大多數應用的是基於硅的集成電路。
是徠20世紀50年代後期到60年代發展起來的一種新型半導體器件。它是經過氧化、光刻、擴散、外延、蒸鋁等半導體製造工藝,把構成具有一定功能的電路所需的半導體、電阻、電容等元件及它們之間的連接導線全部集成在一小塊矽片上,然後焊接封裝在一個管殼內的電子器件。其封裝外殼有圓殼式、扁平式或雙列直插式等多種形式。集成電路技術包括晶元製造技術與設計技術,主要體現在加工設備,加工工藝,封裝測試,批量生產及設計創新的能力上。
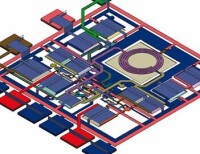
集成電路
集成電路所有元件在結構上已組成一個整體,這樣,整個電路的體積大大縮小,且引出線和焊接點的數目也大為減少,從而使電子元件向著微小型化、低功耗和高可靠性方面邁進了一大步。
《中國集成電路封裝行業市場前瞻與投資戰略規劃分析報告前瞻》顯示,在產業規模快速增長的同時,IC 設計、晶元製造和封裝測試三業的格局也正不斷優化。2010年,國內IC設計業同比增速達到34.8%,規模達到363.85億元;晶元製造業增速也達到31.1%,規模達到447.12億元;封裝測試業增速相對稍緩,同比增幅為26.3%,規模為629.18億元。
總體來看,IC設計業與晶元製造業所佔比重呈逐年上升的趨勢,2010年已分別達到25.3%和31%;封裝測試業所佔比重則相應下降,2010年為43.7%,但其所佔比重依然是最大的。
目前,我國集成電路產業集群已初步形成集聚長三角、環渤海和珠三角三大區域的總體產業空間格局,2010年三大區域集成電路產業銷售收入佔全國整體產業規模的近95%。集成電路產業基本分佈在省會城市和沿海的計劃單列市,並呈現“一軸一帶”的分佈特徵,即東起上海、西至成都的沿江發展軸以及北起大連、南至深圳的沿海產業帶,形成了北京、上海、深圳、無錫、蘇州和杭州六大重點城市。
去年年初,國務院發布了《國務院關於印發進一步鼓勵軟體產業和集成電路產業發展若干政策的通知》,從財稅、投融資、研發、進出口、人才、知識產權等方面給予集成電路產業諸多優惠,政策覆蓋範圍從設計企業與生產企業延伸至封裝、測試、設備、材料等產業鏈上下游企業,產業發展政策環境進一步好轉。前瞻網表示,根據國家規劃,到2015年國內集成電路產業規模將在2010年的基礎上再翻一番,銷售收入超過3000億元,滿足國內30%的市場需求。晶元設計能力大幅提升,開發出一批具有自主知識產權的核心晶元,而封裝測試業進入國際主流領域。“十二五”期間,中國集成電路產業將步入一個新的黃金髮展期。
集成電路或稱微電路(microcircuit)、微晶元(microchip)、晶元(chip)在電子學中是一種把電路(主要包括半導體裝置,也包括被動元件等)小型化的方式,並通常製造在半導體晶圓表面上。
前述將電路製造在半導體晶元表面上的集成電路又稱薄膜(thin-film)集成電路。另有一種厚膜(thick-film)混成集成電路(hybrid integrated circuit)是由獨立半導體設備和被動元件,集成到襯底或線路板所構成的小型化電路。
本文是關於單片(monolithic)集成電路,即薄膜集成電路。
集成電路具有體積小,重量輕,引出線和焊接點少,壽命長,可靠性高,性能好等優點,同時成本低,便於大規模生產。它不僅在工、民用電子設備如收錄機、電視機、計算機等方面得到廣泛的應用,同時在軍事、通訊、遙控等方面也得到廣泛的應用。用集成電路來裝配電子設備,其裝配密度比晶體管可提高几十倍至幾千倍,設備的穩定工作時間也可大大提高。

集成電路
集成電路按其功能、結構的不同,可以分為模擬集成電路、數字集成電路和數/模混合集成電路三大類。
模擬集成電路用來產生、放大和處理各種模擬信號(指幅度隨時間邊疆變化的信號。例如半導體收音機的音頻信號、錄放機的磁帶信號等),而數字集成電路用來產生、放大和處理各種數字信號(指在時間上和幅度上離散取值的信號。例如VCD、DVD重放的音頻信號和視頻信號)。
(二)按製作工藝分類
集成電路按製作工藝可分為半導體集成電路和薄膜集成電路。
膜集成電路又分類厚膜集成電路和薄膜集成電路。

集成電路
集成電路按集成度高低的不同可分為小規模集成電路、中規模集成電路、大規模集成電路、超大規模集成電路、特大規模集成電路和巨大規模集成電路。
(四)按導電類型不同分類
集成電路按導電類型可分為雙極型集成電路和單極型集成電路。
雙極型集成電路的製作工藝複雜,功耗較大,代表集成電路有TTL、ECL、HTL、LST-TL、STTL等類型。單極型集成電路的製作工藝簡單,功耗也較低,易於製成大規模集成電路,代表集成電路有CMOS、NMOS、PMOS等類型。
(五)按用途分類
集成電路按用途可分為電視機用集成電路、音響用集成電路、影碟機用集成電路、錄像機用集成電路、電腦(微機)用集成電路、電子琴用集成電路、通信用集成電路、照相機用集成電路、遙控集成電路、語言集成電路、報警器用集成電路及各種專用集成電路。
1、電視機用集成電路包括行、場掃描集成電路、中放集成電路、伴音集成電路、彩色解碼集成電路、AV/TV轉換集成電路、開關電源集成電路、遙控集成電路、麗音解碼集成電路、畫中畫處理集成電路、微處理器(CPU)集成電路、存儲器集成電路等。
2、音響用集成電路包括AM/FM高中頻電路、立體聲解碼電路、音頻前置放大電路、音頻運算放大集成電路、音頻功率放大集成電路、環繞聲處理集成電路、電平驅動集成電路,電子音量控制集成電路、延時混響集成電路、電子開關集成電路等。
3、影碟機用集成電路有系統控制集成電路、視頻編碼集成電路、MPEG解碼集成電路、音頻信號處理集成電路、音響效果集成電路、RF信號處理集成電路、數字信號處理集成電路、伺服集成電路、電動機驅動集成電路等。
4、錄像機用集成電路有系統控制集成電路、伺服集成電路、驅動集成電路、音頻處理集成電路、視頻處理集成電路。
(六)按大小分
有小規模集成電路
大規模集成電路
超大規模集成電路
(七)按應用領域分
集成電路按應用領域可分為標準通用集成電路和專用集成電路。
世界集成電路的發展歷史 1947年:貝爾實驗室肖克萊等人發明了晶體管,這是微電子技術發展中第一個里程碑;
1950年:結型晶體管誕生;
1950年:ROhl和肖特萊發明了離子注入工藝;
1951年:場效應晶體管發明;
1956年:CSFuller發明了擴散工藝;
1958年:仙童公司RobertNoyce與德儀公司基爾比間隔數月分別發明了集成電路,開創了世界微電子學的歷史;
1960年:HHLoor和ECastellani發明了光刻工藝;
1962年:美國RCA公司研製出MOS場效應晶體管;
1963年:F.M.Wanlass和C.T.Sah首次提出CMOS技術,今天,95%以上的集成電路晶元都是基於CMOS工藝;
1964年:Intel摩爾提出摩爾定律,預測晶體管集成度將會每18個月增加1倍;
1966年:美國RCA公司研製出CMOS集成電路,並研製出第一塊門陣列(50門);
1967年:應用材料公司(AppliedMaterials)成立,現已成為全球最大的半導體設備製造公司;
1971年:Intel推出1kb動態隨機存儲器(DRAM),標誌著大規模集成電路出現;
1971年:全球第一個微處理器4004由Intel公司推出,採用的是MOS工藝,這是一個里程碑式的發明;
1974年:RCA公司推出第一個CMOS微處理器1802;
1976年:16kbDRAM和4kbSRAM問世;
1978年:64kb動態隨機存儲器誕生,不足0.5平方厘米的矽片上集成了14萬個晶體管,標誌著超大規模集成電路(VLSI)時代的來臨;
1979年:Intel推出5MHz8088微處理器,之後,IBM基於8088推出全球第一台PC;
徠1981年:256kbDRAM和64kbCMOSSRAM問世;
1984年:日本宣布推出1MbDRAM和256kbSRAM;
1985年:80386微處理器問世,20MHz;
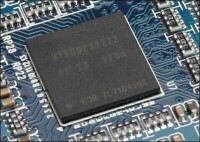
集成電路
1989年:1MbDRAM進入市場;
1989年:486微處理器推出,25MHz,1μm工藝,後來50MHz晶元採用0.8μm工藝;
1992年:64M位隨機存儲器問世;
1993年:66MHz奔騰處理器推出,採用0.6μm工藝;
1995年:PentiumPro,133MHz,採用0.6-0.35μm工藝;
1997年:300MHz奔騰Ⅱ問世,採用0.25μm工藝;
1999年:奔騰Ⅲ問世,450MHz,採用0.25μm工藝,后採用0.18μm工藝;
2000年:1GbRAM投放市場;
2000年:奔騰4問世,1.5GHz,採用0.18μm工藝;
2001年:Intel宣布2001年下半年採用0.13μm工藝。
中國集成電路的發展歷史
中國集成電路產業誕生於六十年代,共經歷了三個發展階段:
1965年-1978年:以計算機和軍工配套為目標,以開發邏輯電路為主要產品,初步建立集成電路工業基礎及相關設備、儀器、材料的配套條件;
1978年-1990年:主要引進美國二手設備,改善集成電路裝備水平,在“治散治亂”的同時,以消費類整機作為配套重點,較好地解決了彩電集成電路的國產化;
1990年-2000年:以908工程、909工程為重點,以CAD為突破口,抓好科技攻關和北方科研開發基地的建設,為信息產業服務,集成電路行業取得了新的發展。
我國集成電路的型號 根據國際,我國集成電路的命名由五部分組成。
第0部分 第一部分 第二部分 第三部分 第四部分
各部分的含義如下
第0部分:用字母表示符合國家標準,C表示中國國際產品。
第一部分:用字母表示器件類型。
第二部分:用數字錶示器件的系列代號。
第三部分:用字母表示器件的工作溫度。
第四部分:用字母表示器件的封裝。
國標GB/T3430—1989半導體集成電路命名方法規定集成電路型號各部分的符合及意義。
例如:肖特基4輸入與非門 CT54S20MD
C—符合國家標準
T—TTL電路
54S20—肖特基雙4輸入與非門
M—‐55~125℃
D—多層陶瓷雙列直插封裝
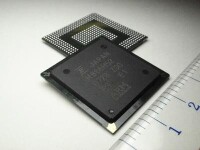
集成電路
球形觸點陳列,表面貼裝型封裝之一。在印刷基板的背面按陳列方式製作出球形凸點用以代替引腳,在印刷基板的正面裝配LSI晶元,然後用模壓樹脂或灌封方法進行密封。也稱為凸點陳列載體(PAC)。引腳可超過200,是多引腳LSI用的一種封裝。封裝本體也可做得比QFP(四側引腳扁平封裝)小。例如,引腳中心距為1.5mm的360引腳BGA僅為31mm見方;而引腳中心距為0.5mm的304引腳QFP為40mm見方。而且BGA不用擔心QFP那樣的引腳變形問題。該封裝是美國Motorola公司開發的,首先在攜帶型電話等設備中被採用,今後在美國有可能在個人計算機中普及。最初,BGA的引腳(凸點)中心距為1.5mm,引腳數為225。現在也有一些LSI廠家正在開發500引腳的BGA。BGA的問題是迴流焊后的外觀檢查。現在尚不清楚是否有效的外觀檢查方法。有的認為,由於焊接的中心距較大,連接可以看作是穩定的,只能通過功能檢查來處理。美國Motorola公司把用模壓樹脂密封的封裝稱為OMPAC,而把灌封方法密封的封裝稱為GPAC(見OMPAC和GPAC)。
2、BQFP(quadflatpackagewithbumper)
帶緩衝墊的四側引腳扁平封裝。QFP封裝之一,在封裝本體的四個角設置突起(緩衝墊)以防止在運送過程中引腳發生彎曲變形。美國半導體廠家主要在微處理器和ASIC等電路中採用此封裝。引腳中心距0.635mm,引腳數從84到196左右(見QFP)。
4、C-(ceramic)
表示陶瓷封裝的記號。例如,CDIP表示的是陶瓷DIP。是在實際中經常使用的記號。
5、Cerdip
用玻璃密封的陶瓷雙列直插式封裝,用於ECLRAM,DSP(數字信號處理器)等電路。帶有玻璃窗口的Cerdip用於紫外線擦除型EPROM以及內部帶有EPROM的微機電路等。引腳中心距2.54mm,引腳數從8到42。在日本,此封裝表示為DIP-G(G即玻璃密封的意思)。
6、Cerquad
表面貼裝型封裝之一,即用下密封的陶瓷QFP,用於封裝DSP等的邏輯LSI電路。帶有窗口的Cerquad用於封裝EPROM電路。散熱性比塑料QFP好,在自然空冷條件下可容許1.5~2W的功率。但封裝成本比塑料QFP高3~5倍。引腳中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm等多種規格。引腳數從32到368。
帶引腳的陶瓷晶元載體,表面貼裝型封裝之一,引腳從封裝的四個側面引出,呈丁字形。帶有窗口的用於封裝紫外線擦除型EPROM以及帶有EPROM的微機電路等。此封裝也稱為QFJ、QFJ-G(見QFJ)。

集成電路
板上晶元封裝,是裸晶元貼裝技術之一,半導體晶元交接貼裝在印刷線路板上,晶元與基板的電氣連接用引線縫合方法實現,晶元與基板的電氣連接用引線縫合方法實現,並用樹脂覆蓋以確保可靠性。雖然COB是最簡單的裸晶元貼裝技術,但它的封裝密度遠不如TAB和倒片焊技術。
9、DFP(dualflatpackage)
雙側引腳扁平封裝。是SOP的別稱(見SOP)。以前曾有此稱法,現在已基本上不用。
10、DIC(dualin-lineceramiCPACkage)
陶瓷DIP(含玻璃密封)的別稱(見DIP).
11、DIL(dualin-line)
DIP的別稱(見DIP)。歐洲半導體廠家多用此名稱。
12、DIP(dualin-linepackage)
雙列直插式封裝。插裝型封裝之一,引腳從封裝兩側引出,封裝材料有塑料和陶瓷兩種。DIP是最普及的插裝型封裝,應用範圍包括標準邏輯IC,存貯器LSI,微機電路等。引腳中心距2.54mm,引腳數從6到64。封裝寬度通常為15.2mm。有的把寬度為7.52mm和10.16mm的封裝分別稱為skinnyDIP和slimDIP(窄體型DIP)。但多數情況下並不加區分,只簡單地統稱為DIP。另外,用低熔點玻璃密封的陶瓷DIP也稱為cerdip(見cerdip)。
13、DSO(dualsmallout-lint)
雙側引腳小外形封裝。SOP的別稱(見SOP)。部分半導體廠家採用此名稱。
14、dicp(dualtapecarrierpackage)
雙側引腳帶載封裝。TCP(帶載封裝)之一。引腳製作在絕緣帶上並從封裝兩側引出。由於利用的是TAB(自動帶載焊接)技術,封裝外形非常薄。常用於液晶顯示驅動LSI,但多數為定製品。另外,0.5mm厚的存儲器LSI簿形封裝正處於開發階段。在日本,按照EIAJ(日本電子機械工業)會標準規定,將DICP命名為DTP。
15、DIP(dualtapecarrierpackage)
同上。日本電子機械工業會標準對DTCP的命名(見DTCP)。
16、FP(flatpackage)
扁平封裝。表面貼裝型封裝之一。QFP或SOP(見QFP和SOP)的別稱。部分半導體廠家採用此名稱。
17、flip-chip
倒焊晶元。裸晶元封裝技術之一,在LSI晶元的電極區製作好金屬凸點,然後把金屬凸點與印刷基板上的電極區進行壓焊連接。封裝的佔有面積基本上與晶元尺寸相同。是所有封裝技術中體積最小、最薄的一種。但如果基板的熱膨脹係數與LSI晶元不同,就會在接合處產生反應,從而影響連接的可靠性。因此必須用樹脂來加固LSI晶元,並使用熱膨脹係數基本相同的基板材料。

集成電路
小引腳中心距QFP。通常指引腳中心距小於0.65mm的QFP(見QFP)。部分導導體廠家採用此名稱。
19、CPAC(globetoppadarraycarrier)
美國Motorola公司對BGA的別稱(見BGA)。
20、CQFP(quadfiatpackagewithguardring)
帶保護環的四側引腳扁平封裝。塑料QFP之一,引腳用樹脂保護環掩蔽,以防止彎曲變形。在把LSI組裝在印刷基板上之前,從保護環處切斷引腳並使其成為海鷗翼狀(L形狀)。這種封裝在美國Motorola公司已批量生產。引腳中心距0.5mm,引腳數最多為208左右。
21、H-(withheatsink)
表示帶散熱器的標記。例如,HSOP表示帶散熱器的SOP。
22、pingridarray(surfacemounttype)
表面貼裝型PGA。通常PGA為插裝型封裝,引腳長約3.4mm。表面貼裝型PGA在封裝的底面有陳列狀的引腳,其長度從1.5mm到2.0mm。貼裝採用與印刷基板碰焊的方法,因而也稱為碰焊PGA。因為引腳中心距只有1.27mm,比插裝型PGA小一半,所以封裝本體可製作得不怎麼大,而引腳數比插裝型多(250~528),是大規模邏輯LSI用的封裝。封裝的基材有多層陶瓷基板和玻璃環氧樹脂印刷基數。以多層陶瓷基材製作封裝已經實用化。
23、jlcc(J-leadedchipcarrier)
J形引腳晶元載體。指帶窗口CLCC和帶窗口的陶瓷QFJ的別稱(見CLCC和QFJ)。部分半導體廠家採用的名稱。
24、LCC(Leadlesschipcarrier)
無引腳晶元載體。指陶瓷基板的四個側面只有電極接觸而無引腳的表面貼裝型封裝。是高速和高頻IC用封裝,也稱為陶瓷QFN或QFN-C(見QFN)。
25、LGA(landgridarray)
觸點陳列封裝。即在底面製作有陣列狀態坦電極觸點的封裝。裝配時插入插座即可。現已實用的有227觸點(1.27mm中心距)和447觸點(2.54mm中心距)的陶瓷LGA,應用於高速邏輯LSI電路。LGA與QFP相比,能夠以比較小的封裝容納更多的輸入輸出引腳。另外,由於引線的阻抗小,對於高速LSI是很適用的。但由於插座製作複雜,成本高,現在基本上不怎麼使用。預計今後對其需求會有所增加。
26、LOC(leadonchip)
晶元上引線封裝。LSI封裝技術之一,引線框架的前端處於晶元上方的一種結構,晶元的中心附近製作有凸焊點,用引線縫合進行電氣連接。與原來把引線框架布置在晶元側面附近的結構相比,在相同大小的封裝中容納的晶元達1mm左右寬度。

集成電路
薄型QFP。指封裝本體厚度為1.4mm的QFP,是日本電子機械工業會根據制定的新QFP外形規格所用的名稱。
28、L-QUAD
陶瓷QFP之一。封裝基板用氮化鋁,基導熱率比氧化鋁高7~8倍,具有較好的散熱性。封裝的框架用氧化鋁,晶元用灌封法密封,從而抑制了成本。是為邏輯LSI開發的一種封裝,在自然空冷條件下可容許W3的功率。現已開發出了208引腳(0.5mm中心距)和160引腳(0.65mm中心距)的LSI邏輯用封裝,並於1993年10月開始投入批量生產。
29、MCM(multi-chipmodule)
多晶元組件。將多塊半導體裸晶元組裝在一塊布線基板上的一種封裝。根據基板材料可分為MCM-L,MCM-C和MCM-D三大類。MCM-L是使用通常的玻璃環氧樹脂多層印刷基板的組件。布線密度不怎麼高,成本較低。MCM-C是用厚膜技術形成多層布線,以陶瓷(氧化鋁或玻璃陶瓷)作為基板的組件,與使用多層陶瓷基板的厚膜混合IC類似。兩者無明顯差別。布線密度高於MCM-L。
MCM-D是用薄膜技術形成多層布線,以陶瓷(氧化鋁或氮化鋁)或Si、Al作為基板的組件。布線密謀在三種組件中是最高的,但成本也高。
30、MFP(miniflatpackage)
小形扁平封裝。塑料SOP或SSOP的別稱(見SOP和SSOP)。部分半導體廠家採用的名稱。
31、MQFP(metricquadflatpackage)
按照JEDEC(美國聯合電子設備委員會)標準對QFP進行的一種分類。指引腳中心距為0.65mm、本體厚度為3.8mm~2.0mm的標準QFP(見QFP)。
32、MQUAD(metalquad)
美國Olin公司開發的一種QFP封裝。基板與封蓋均採用鋁材,用粘合劑密封。在自然空冷條件下可容許2.5W~2.8W的功率。日本新光電氣工業公司於1993年獲得特許開始生產。
33、MSP(minisquarepackage)
QFI的別稱(見QFI),在開發初期多稱為MSP。QFI是日本電子機械工業會規定的名稱。
34、OPMAC(overmoldedpadarraycarrier)
模壓樹脂密封凸點陳列載體。美國Motorola公司對模壓樹脂密封BGA採用的名稱(見BGA)。
35、P-(plastic)
表示塑料封裝的記號。如PDIP表示塑料DIP。
36、PAC(padarraycarrier)
凸點陳列載體,BGA的別稱(見BGA)。
37、PCLP(printedcircuitboardleadlesspackage)
印刷電路板無引線封裝。日本富士通公司對塑料QFN(塑料LCC)採用的名稱(見QFN)。引
腳中心距有0.55mm和0.4mm兩種規格。目前正處於開發階段。
38、pfpf(plasticflatpackage)
塑料扁平封裝。塑料QFP的別稱(見QFP)。部分LSI廠家採用的名稱。

集成電路
陳列引腳封裝。插裝型封裝之一,其底面的垂直引腳呈陳列狀排列。封裝基材基本上都採用多層陶瓷基板。在未專門表示出材料名稱的情況下,多數為陶瓷PGA,用於高速大規模邏輯LSI電路。成本較高。引腳中心距通常為2.54mm,引腳數從64到447左右。了為降低成本,封裝基材可用玻璃環氧樹脂印刷基板代替。也有64~256引腳的塑料PGA。另外,還有一種引腳中心距為1.27mm的短引腳表面貼裝型PGA(碰焊PGA)。(見表面貼裝型PGA)。
40、piggyback
馱載封裝。指配有插座的陶瓷封裝,形關與DIP、QFP、QFN相似。在開發帶有微機的設備時用於評價程序確認操作。例如,將EPROM插入插座進行調試。這種封裝基本上都是定製品,市場上不怎麼流通。
41、PLCC(plasticleadedchipcarrier)
帶引線的塑料晶元載體。表面貼裝型封裝之一。引腳從封裝的四個側面引出,呈丁字形,是塑料製品。美國德克薩斯儀器公司首先在64k位DRAM和256kDRAM中採用,現在已經普及用於邏輯LSI、DLD(或程邏輯器件)等電路。引腳中心距1.27mm,引腳數從18到84。J形引腳不易變形,比QFP容易操作,但焊接后的外觀檢查較為困難。PLCC與LCC(也稱QFN)相似。以前,兩者的區別僅在於前者用塑料,後者用陶瓷。但現在已經出現用陶瓷製作的J形引腳封裝和用塑料製作的無引腳封裝(標記為塑料LCC、PCLP、P-LCC等),已經無法分辨。為此,日本電子機械工業會於1988年決定,把從四側引出J形引腳的封裝稱為QFJ,把在四側帶有電極凸點的封裝稱為QFN(見QFJ和QFN)。
42、P-LCC(plasticteadlesschipcarrier)(plasticleadedchipcurrier)
有時候是塑料QFJ的別稱,有時候是QFN(塑料LCC)的別稱(見QFJ和QFN)。部分
LSI廠家用PLCC表示帶引線封裝,用P-LCC表示無引線封裝,以示區別。
43、QFH(quadflathighpackage)
四側引腳厚體扁平封裝。塑料QFP的一種,為了防止封裝本體斷裂,QFP本體製作得較厚(見QFP)。部分半導體廠家採用的名稱。
44、QFI(quadflatI-leadedpackgac)
四側I形引腳扁平封裝。表面貼裝型封裝之一。引腳從封裝四個側面引出,向下呈I字。也稱為MSP(見MSP)。貼裝與印刷基板進行碰焊連接。由於引腳無突出部分,貼裝佔有面積小於QFP。日立製作所為視頻模擬IC開發並使用了這種封裝。此外,日本的Motorola公司的PLLIC也採用了此種封裝。引腳中心距1.27mm,引腳數從18於68。
45、QFJ(quadflatJ-leadedpackage)
四側J形引腳扁平封裝。表面貼裝封裝之一。引腳從封裝四個側面引出,向下呈J字形。是日本電子機械工業會規定的名稱。引腳中心距1.27mm。
材料有塑料和陶瓷兩種。塑料QFJ多數情況稱為PLCC(見PLCC),用於微機、門陳列、DRAM、ASSP、OTP等電路。引腳數從18至84。
陶瓷QFJ也稱為CLCC、JLCC(見CLCC)。帶窗口的封裝用於紫外線擦除型EPROM以及帶有EPROM的微機晶元電路。引腳數從32至84。

集成電路
四側無引腳扁平封裝。表面貼裝型封裝之一。現在多稱為LCC。QFN是日本電子機械工業會規定的名稱。封裝四側配置有電極觸點,由於無引腳,貼裝佔有面積比QFP小,高度比QFP低。但是,當印刷基板與封裝之間產生應力時,在電極接觸處就不能得到緩解。因此電極觸點難於作到QFP的引腳那樣多,一般從14到100左右。材料有陶瓷和塑料兩種。當有LCC標記時基本上都是陶瓷QFN。電極觸點中心距1.27mm。
塑料QFN是以玻璃環氧樹脂印刷基板基材的一種低成本封裝。電極觸點中心距除1.27mm外,還有0.65mm和0.5mm兩種。這種封裝也稱為塑料LCC、PCLC、P-LCC等。
47、QFP(quadflatpackage)
四側引腳扁平封裝。表面貼裝型封裝之一,引腳從四個側面引出呈海鷗翼(L)型。基材有陶瓷、金屬和塑料三種。從數量上看,塑料封裝占絕大部分。當沒有特別表示出材料時,多數情況為塑料QFP。塑料QFP是最普及的多引腳LSI封裝。不僅用於微處理器,門陳列等數字邏輯LSI電路,而且也用於VTR信號處理、音響信號處理等模擬LSI電路。引腳中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm等多種規格。0.65mm中心距規格中最多引腳數為304。
日本將引腳中心距小於0.65mm的QFP稱為QFP(FP)。但現在日本電子機械工業會對QFP的外形規格進行了重新評價。在引腳中心距上不加區別,而是根據封裝本體厚度分為QFP(2.0mm~3.6mm厚)、LQFP(1.4mm厚)和TQFP(1.0mm厚)三種。
另外,有的LSI廠家把引腳中心距為0.5mm的QFP專門稱為收縮型QFP或SQFP、VQFP。但有的廠家把引腳中心距為0.65mm及0.4mm的QFP也稱為SQFP,至使名稱稍有一些混亂。QFP的缺點是,當引腳中心距小於0.65mm時,引腳容易彎曲。為了防止引腳變形,現已出現了幾種改進的QFP品種。如封裝的四個角帶有樹指緩衝墊的BQFP(見BQFP);帶樹脂保護環覆蓋引腳前端的GQFP(見GQFP);在封裝本體里設置測試凸點、放在防止引腳變形的專用夾具里就可進行測試的TPQFP(見TPQFP)。在邏輯LSI方面,不少開發品和高可靠品都封裝在多層陶瓷QFP里。引腳中心距最小為0.4mm、引腳數最多為348的產品也已問世。此外,也有用玻璃密封的陶瓷QFP(見Gerqad)。
48、QFP(FP)(QFPfinepitch)
小中心距QFP。日本電子機械工業會標準所規定的名稱。指引腳中心距為0.55mm、0.4mm、0.3mm等小於0.65mm的QFP(見QFP)。
49、QIC(quadin-lineceramicpackage)
陶瓷QFP的別稱。部分半導體廠家採用的名稱(見QFP、Cerquad)。
50、QIP(quadin-lineplasticpackage)
塑料QFP的別稱。部分半導體廠家採用的名稱(見QFP)。
51、QTCP(quadtapecarrierpackage)
四側引腳帶載封裝。TCP封裝之一,在絕緣帶上形成引腳並從封裝四個側面引出。是利用TAB技術的薄型封裝(見TAB、TCP)。

集成電路
四側引腳帶載封裝。日本電子機械工業會於1993年4月對QTCP所制定的外形規格所用的名稱(見TCP)。
53、QUIL(quadin-line)
quip的別稱(見QUIP)。
54、QUIP(quadin-linepackage)
四列引腳直插式封裝。引腳從封裝兩個側面引出,每隔一根交錯向下彎曲成四列。引腳中心距1.27mm,當插入印刷基板時,插入中心距就變成2.5mm。因此可用於標準印刷線路板。是比標準DIP更小的一種封裝。日本電氣公司在台式計算機和家電產品等的微機晶元中採用了些種封裝。材料有陶瓷和塑料兩種。引腳數64。
55、SDIP(shrinkdualin-linepackage)
收縮型DIP。插裝型封裝之一,形狀與DIP相同,但引腳中心距(1.778mm)小於DIP(2.54mm),
因而得此稱呼。引腳數從14到90。也有稱為SH-DIP的。材料有陶瓷和塑料兩種。
56、SH-DIP(shrinkdualin-linepackage)
同SDIP。部分半導體廠家採用的名稱。
57、SIL(singlein-line)
SIP的別稱(見SIP)。歐洲半導體廠家多採用SIL這個名稱。
58、SIMM(singlein-linememorymodule)
單列存貯器組件。只在印刷基板的一個側面附近配有電極的存貯器組件。通常指插入插座的組件。標準SIMM有中心距為2.54mm的30電極和中心距為1.27mm的72電極兩種規格。在印刷基板的單面或雙面裝有用SOJ封裝的1兆位及4兆位DRAM的SIMM已經在個人計算機、工作站等設備中獲得廣泛應用。至少有30~40%的DRAM都裝配在SIMM里。
59、SIP(singlein-linepackage)
單列直插式封裝。引腳從封裝一個側面引出,排列成一條直線。當裝配到印刷基板上時封裝呈側立狀。引腳中心距通常為2.54mm,引腳數從2至23,多數為定製產品。封裝的形狀各異。也有的把形狀與ZIP相同的封裝稱為SIP。
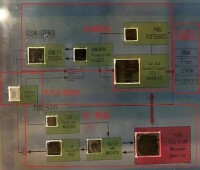
集成電路
DIP的一種。指寬度為7.62mm、引腳中心距為2.54mm的窄體DIP。通常統稱為DIP(見DIP)。
61、SL-DIP(slimdualin-linepackage)
DIP的一種。指寬度為10.16mm,引腳中心距為2.54mm的窄體DIP。通常統稱為DIP。
62、SMD(surfacemountdevices)
表面貼裝器件。偶而,有的半導體廠家把SOP歸為SMD(見SOP)。
SOP的別稱。世界上很多半導體廠家都採用此別稱。(見SOP)。
64、SOI(smallout-lineI-leadedpackage)
I形引腳小外型封裝。表面貼裝型封裝之一。引腳從封裝雙側引出向下呈I字形,中心距1.27mm。貼裝佔有面積小於SOP。日立公司在模擬IC(電機驅動用IC)中採用了此封裝。引腳數26。
65、SOIC(smallout-lineintegratedcircuit)
SOP的別稱(見SOP)。國外有許多半導體廠家採用此名稱。
66、SOJ(SmallOut-LineJ-LeadedPackage)
J形引腳小外型封裝。表面貼裝型封裝之一。引腳從封裝兩側引出向下呈J字形,故此得名。通常為塑料製品,多數用於DRAM和SRAM等存儲器LSI電路,但絕大部分是DRAM。用SOJ封裝的DRAM器件很多都裝配在SIMM上。引腳中心距1.27mm,引腳數從20至40(見SIMM)。
67、SQL(SmallOut-LineL-leadedpackage)
按照JEDEC(美國聯合電子設備工程委員會)標準對SOP所採用的名稱(見SOP)。
68、SONF(SmallOut-LineNon-Fin)
無散熱片的SOP。與通常的SOP相同。為了在功率IC封裝中表示無散熱片的區別,有意增添了NF(non-fin)標記。部分半導體廠家採用的名稱(見SOP)。
69、SOP(smallOut-Linepackage)
小外形封裝。表面貼裝型封裝之一,引腳從封裝兩側引出呈海鷗翼狀(L字形)。材料有塑料和陶瓷兩種。另外也叫SOL和DFP。
SOP除了用於存儲器LSI外,也廣泛用於規模不太大的ASSP等電路。在輸入輸出端子不超過10~40的領域,SOP是普及最廣的表面貼裝封裝。引腳中心距1.27mm,引腳數從8~44。
另外,引腳中心距小於1.27mm的SOP也稱為SSOP;裝配高度不到1.27mm的SOP也稱為TSOP(見SSOP、TSOP)。還有一種帶有散熱片的SOP。
70、SOW(SmallOutlinePackage(Wide-Jype))
寬體SOP。部分半導體廠家採用的名稱。
通常一台設備裡面有許多個集成電路,當拿到一部有故障的集成電路的設備時,想要找到故障所在必須通過檢測,集成電路行之有效的檢測方法包括:
1.微處理器集成電路的檢測
微處理器集成電路的關鍵測試引腳是VDD電源端、RESET複位端、XIN 晶振信號輸入端、XOUT晶振信號輸出端及其他各線輸入、輸出端。在路測量這些關鍵腳對地的電阻值和電壓值,看是否與正常值(可從產品電路圖或有關維修資 料中查出)相同。不同型號微處理器的RESET複位電壓也不相同,有的是低電平複位,即在開機瞬間為低電平,複位后維持高電平;有的是高電平複位,即在開 關瞬間為高電平,複位后維持低電平。
2.開關電源集成電路的檢測
開關電源集成電路的關鍵腳電壓是電源端(VCC)、激勵脈衝輸出端、電壓檢測輸入端、電流檢測輸入端。測量各引腳對地的電壓值和電阻值,若與正常值相差較大,在其外圍元器件正常的情況下,可以確定是該集成電路已損壞。內置大功率開關管的厚膜集成電路,還可通過測量開關管C、B、E極之間的正、反向電阻值,來判斷開關管是否正常。
3.音頻功放集成電路的檢測
檢查音頻功放集成電路時,應先檢測其電源端(正電源端和負電源端)、音頻 輸入端、音頻輸出端及反饋端對地的電壓值和電阻值。若測得各引腳的數據值與正常值相差較大,其外圍元件與正常,則是該集成電路內部損壞。對引起無聲故障的 音頻功放集成電路,測量其電源電壓正常時,可用信號干擾法來檢查。測量時,萬用表應置於R×1檔,將紅表筆接地,用黑表筆點觸音頻輸入端,正常時揚聲器中 應有較強的“喀喀”聲。
4.運算放大器集成電路的檢測
用萬用表直流電壓檔,測量運算放大器輸出端與負電源端之間的電壓值(在靜態時電壓值較高)。用手持金屬鑷子依次點觸運算放大器的兩個輸入端(加入干擾信號),若萬用表錶針有較大幅度的擺動,則說明該運算放大器完好;若萬用表錶針不動,則說明運算放大器已損壞。
5.時基集成電路的檢測
時基集成電路內含數字電路和模擬電路,用萬用表很難直接測出其好壞。測試電路由阻容元件、發光二極體LED、6V直流電源、電源開關S和8腳IC插座組成。將時基集 成電路(例如NE555)插信IC插座后,按下電源開關S,若被測時基集成電路正常,則發光二極體LED將閃爍發光;若LED不亮或一直亮,則說明被測時基集成電路性能不良。
1、檢測前要了解集成電路及其相關電路的工作原理。檢查和修理集成電路前首先要熟悉所用集成電路的功能、內部電路、主要電氣參數、各引腳的作用以及引腳的正常電壓、波形與外圍元件組成電路的工作原理。如果具備以上條件,那麼分析和檢查會容易許多。
2、測試不要造成引腳間短路。電壓測量或用示波器探頭測試波形時,表筆或探頭不要由於滑動而造成集成電路引腳間短路,最好在與引腳直接連通的外圍印刷電路上進行測量。任何瞬間的短路都容易損壞集成電路,在測試扁平型封裝的CMOS集成電路時更要加倍小心。
3、嚴禁在無隔離變壓器的情況下,用已接地的測試設備去接觸底板帶電的電視、音響、錄像等設備。嚴禁用外殼已接地的儀器設備直接測試無電源隔離變壓器的電視、音響、錄像等設備。雖然一般的收錄機都具有電源變壓器,當接觸到較特殊的尤其是輸出功率較大或對採用的電源性質不太了解的電視或音響設備時,首先要弄清該機底盤是否帶電,否則極易與底板帶電的電視、音響等設備造成電源短路,波及集成電路,造成故障的進一步擴大。
5、要保證焊接質量。焊接時確實焊牢,焊錫的堆積、氣孔容易造成虛焊。焊接時間一般不超過3秒鐘,烙鐵的功率應用內熱式25W左右。已焊接好的集成電路要仔細查看,最好用歐姆表測量各引腳間有否短路,確認無焊錫粘連現象再接通電源。
6、不要輕易斷定集成電路的損壞。不要輕易地判斷集成電路已損壞。因為集成電路絕大多數為直接耦合,一旦某一電路不正常,可能會導致多處電壓變化,而這些變化不一定是集成電路損壞引起的,另外在有些情況下測得各引腳電壓與正常值相符或接近時,也不一定都能說明集成電路就是好的。因為有些軟故障不會引起直流電壓的變化。
7、測試儀錶內阻要大。測量集成電路引腳直流電壓時,應選用表頭內阻大於20KΩ/V的萬用表,否則對某些引腳電壓會有較大的測量誤差。
8、要注意功率集成電路的散熱。功率集成電路應散熱良好,不允許不帶散熱器而處於大功率的狀態下工作。
9、引線要合理。如需要加接外圍元件代替集成電路內部已損壞部分,應選用小型元器件,且接線要合理以免造成不必要的寄生耦合,尤其是要處理好音頻功放集成電路和前置放大電路之間的接地端。
晶體管發明並大量生產之後,各式固態半導體組件如二極體、晶體管等大量使用,取代了真空管在電路中的功能與角色。到了20世紀中後期半導體製造技術進步,使得集成電路成為可能。相對於手工組裝電路使用個別的分立電子組件,集成電路可以把很大數量的微晶體管集成到一個小晶元,是一個巨大的進步。集成電路的規模生產能力,可靠性,電路設計的模塊化方法確保了快速採用標準化IC 代替了設計使用離散晶體管。
IC 對於離散晶體管有兩個主要優勢:成本和性能。成本低是由於晶元把所有的組件通過照相平版技術,作為一個單位印刷,而不是在一個時間只製作一個晶體管。性能高是由於組件快速開關,消耗更低能量,因為組件很小且彼此靠近。2006年,晶元面積從幾平方毫米到350 mm2,每mm2可以達到一百萬個晶體管。
第一個集成電路雛形是由傑克·基爾比於1958年完成的,其中包括一個雙極性晶體管,三個電阻和一個電容器。
根據一個晶元上集成的微電子器件的數量,集成電路可以分為以下幾類:
1.小規模集成電路
SSI 英文全名為 Small Scale Integration, 邏輯門10個以下 或 晶體管 100個以下。
2.中規模集成電路
MSI 英文全名為 Medium Scale Integration, 邏輯門11~100個 或 晶體管 101~1k個。
3.大規模集成電路
LSI 英文全名為 Large Scale Integration, 邏輯門101~1k個 或 晶體管 1,001~10k個。
4.超大規模集成電路
VLSI 英文全名為 Very large scale integration, 邏輯門1,001~10k個 或 晶體管 10,001~100k個。
5.甚大規模集成電路
ULSI 英文全名為 Ultra Large Scale Integration, 邏輯門10,001~1M個 或 晶體管 100,001~10M個。
GLSI 英文全名為 Giga Scale Integration, 邏輯門1,000,001個以上 或 晶體管10,000,001個以上。
而根據處理信號的不同,可以分為模擬集成電路、數字集成電路、和兼具模擬與數字的混合信號集成電路。
最先進的集成電路是微處理器或多核處理器的"核心(cores)",可以控制電腦到手機到數字微波爐的一切。存儲器和ASIC是其他集成電路家族的例子,對於現代信息社會非常重要。雖然設計開發一個複雜集成電路的成本非常高,但是當分散到通常以百萬計的產品上,每個IC的成本最小化。IC的性能很高,因為小尺寸帶來短路徑,使得低功率邏輯電路可以在快速開關速度應用。
這些年來,IC 持續向更小的外型尺寸發展,使得每個晶元可以封裝更多的電路。這樣增加了每單位面積容量,可以降低成本和增加功能-見摩爾定律,集成電路中的晶體管數量,每兩年增加一倍。總之,隨著外形尺寸縮小,幾乎所有的指標改善了-單位成本和開關功率消耗下降,速度提高。但是,集成納米級別設備的IC不是沒有問題,主要是泄漏電流(leakage current)。因此,對於最終用戶的速度和功率消耗增加非常明顯,製造商面臨使用更好幾何學的尖銳挑戰。這個過程和在未來幾年所期望的進步,在半導體國際技術路線圖(ITRS)中有很好的描述。
越來越多的電路以集成晶元的方式出現在設計師手裡,使電子電路的開發趨向於小型化、高速化。越來越多的應用已經由複雜的模擬電路轉化為簡單的數字邏輯集成電路。
僅僅在其開發後半個世紀,集成電路變得無處不在,電腦,手機和其他數字電器成為現代社會結構不可缺少的一部分。這是因為,現代計算,交流,製造和交通系統,包括網際網路,全都依賴於集成電路的存在。甚至很多學者認為有集成電路帶來的數字革命是人類歷史中最重要的事件。
集成電路的分類方法很多,依照電路屬模擬或數字,可以分為:模擬集成電路、數字集成電路和混合信號集成電路(模擬和數字在一個晶元上)。
數字集成電路可以包含任何東西,在幾平方毫米上有從幾千到百萬的邏輯門,觸發器,多任務器和其他電路。這些電路的小尺寸使得與板級集成相比,有更高速度,更低功耗並降低了製造成本。這些數字IC, 以微處理器,數字信號處理器(DSP)和單片機為代表,工作中使用二進位,處理1和0信號。
模擬集成電路有,例如感測器,電源控制電路和運放,處理模擬信號。完成放大,濾波,解調,混頻的功能等。通過使用專家所設計、具有良好特性的模擬集成電路,減輕了電路設計師的重擔,不需凡事再由基礎的一個個晶體管處設計起。
IC可以把模擬和數字電路集成在一個單晶元上,以做出如模擬數字轉換器(A/D converter)和數字模擬轉換器(D/A converter)等器件。這種電路提供更小的尺寸和更低的成本,但是對於信號衝突必須小心。
隨著全球半導體市場發展步伐的逐步拉大,現階段,中國集成電路產業與國外相比差距較大,自身的創新力不足以及產業發展中埋伏的諸多隱患,使得我國集成電路產業面臨著一系列的挑戰。表現之一是產業鏈條上的相關企業多處於單兵作戰狀態,產業脫節的局面始終未得到重視和改觀。集成電路產業是國家基礎性、戰略性、先導性產業,是電子信息產業的核心與基礎,是一個國家經濟發展、科技發展的重要標誌。近年來,在旺盛的市場需求和技術發展的帶動下,我國集成電路產業發展勢頭十分強勁。
2014年6月,全國集成電路產量為904,495.48萬塊,同比增長8.54%,2014年1-6月全國集成電路產量為4,711,807.45萬塊,同比增長9.18%。
2020年7月30日,國務院學位委員會會議投票通過集成電路專業將作為一級學科,並將從電子科學與技術一級學科中獨立出來的提案。集成電路專業擬設於新設的交叉學科門類下,待國務院批准后,將與交叉學科門類一起公布。
