反應離子刻蝕
微電子干法腐蝕工藝
RIE,全稱是Reactive Ion Etching,反應離子刻蝕,一種微電子干法腐蝕工藝。是干蝕刻的一種,這種蝕刻的原理是,當在平板電極之間施加10~100MHZ的高頻電壓(RF,radio frequency)時會產生數百微米厚的離子層(ion sheath),在其中放入試樣,離子高速撞擊試樣而完成化學反應蝕刻,此即為RIE(Reactive Ion Etching)。
為得到高速而垂直的蝕刻面,經加速的多數離子不能與其他氣體分子等碰撞,而直接向試樣撞擊。為達到此目的,必須對真空度,氣體流量,離子加速電壓等進行最佳調整,同時,為得到高密度的等離子體,需用磁控管施加磁場,以提高加工能力。
蝕刻的垂直度和條痕很大程度上受到蝕刻掩模的選擇比及其掩模圖樣形狀的影響。有了高選擇比且優異圖樣形狀的掩模就能保證蝕刻面的性質。但很多時候,兩者很難兼得。對石英系列波導,通常用CF4,C3F8等CF系列的氣體來蝕刻,這些氣體與Cr的選擇比是數千,比非晶硅高一個數量級,然而Cr本身很難形成無條痕的掩模,亦即它的圖樣形狀不好,因此,高選擇比反而會把其掩模的條痕反應到刻蝕面上,帶來刻蝕面粗糙度的劣化。雖然非晶硅形成層必須比Cr掩模厚,但由於容易得到良好形狀,因此仍使用該掩模得到粗糙度為20nm的良好刻蝕面。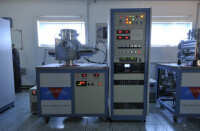
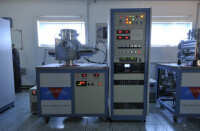
反應離子刻蝕
電荷交換的平均自由程與氣體分子密度成反比關係,因此密度過高,平均自由程太小(和離子層相近或相等),會使得離子之間碰撞的幾率變大,離子垂直碰撞試樣的幾率也就變小,不利於蝕刻形成垂直壁,因此氣體分子密度不能過大。
為實現高速且高深寬比的刻蝕,需要產生高密度的等離子體;而離子層內的離子,也要盡量不碰撞其他氣體分子而直接撞擊試樣。前者需要產生的電子在真空室內與其他氣體分子反覆碰撞;後者,需要盡量增大離子層內的平均自由程,即要求離子層內有低的氣體分子密度。要使得離子層內離子充分發揮離子性能,就需要滿足:
1、必須有反應生成物容易揮發的高真空,即低壓;或者,生成在低真空中也容易揮發的反應生成物,這樣,便有離子層內低的氣體分子密度,形成大的平均自由程;
2、大的離子體密度;
3、反應氣體與掩模的蝕刻選擇比高;
而為產生高密度離子,可以施加磁場,用洛倫茲力使電子沿著擺線軌跡與氣體分子更劇烈的碰撞。也有報道從外部將加速的大電流電子束打入等離子室,產生高密度的電子束來激勵等離子體的(EBEP,electron beam excitedplasma)。
反應離子刻蝕機的整個真空壁接地,作為陽極,陰極是功率電極,陰極側面的接地屏蔽罩可防止功率電極受到濺射。要腐蝕的基片放在功率電極上。腐蝕氣體按照一定的工作壓力和搭配比例充滿整個反應室。對反應腔中的腐蝕氣體,加上大於氣體擊穿臨界值的高頻電場,在強電場作用下,被高頻電場加速的雜散電子與氣體分子或原子進行隨機碰撞,當電子能量大到一定程度時,隨機碰撞變為非彈性碰撞,產生二次電子發射,它們又進一步與氣體分子碰撞,不斷激發或電離氣體分子。這種激烈碰撞引起電離和複合。當電子的產生和消失過程達到平衡時,放電能繼續不斷地維持下去。由非彈性碰撞產生的離子、電子及及遊離基(遊離態的原子、分子或原子團)也稱為等離子體,具有很強的化學活性,可與被刻蝕樣品表面的原子起化學反應,形成揮發性物質,達到腐蝕樣品表層的目的。同時,由於陰極附近的電場方向垂直於陰極表面,高能離子在一定的工作壓力下,垂直地射向樣品表面,進行物理轟擊,使得反應離子刻蝕具有很好的各向異性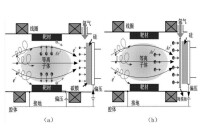
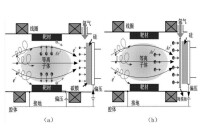
反應離子刻蝕工作原理
存在其他類型的RIE系統,包括電感耦合等離子體(ICP)RIE。在這種類型的系統中,利用RF供電的磁場產生等離子體。雖然蝕刻輪廓傾向於更加各向同性,但可以實現非常高的等離子體密度。典型的RIE系統包括圓柱形真空室,晶片盤位於室的底部。晶片盤與腔室的其餘部分電隔離。氣體通過腔室頂部的小入口進入,並通過底部離開真空泵系統。所用氣體的類型和數量取決於蝕刻工藝;例如,六氟化硫通常用於蝕刻硅。通過調節氣體流速和/或調節排氣孔,氣體壓力通常保持在幾毫托和幾百毫托之間的範圍內。平行板和電感耦合等離子體RIE的組合是可能的。在該系統中,ICP被用作高密度離子源,其增加了蝕刻速率,而單獨的RF偏壓被施加到襯底(硅晶片)以在襯底附近產生定向電場以實現更多的各向異性蝕刻輪廓。

反應離子刻蝕
通過向晶片碟片施加強RF電磁場,在系統中啟動等離子體。該場通常設定為13.56兆赫茲的頻率,施加在幾百瓦特。振蕩電場通過剝離電子來電離氣體分子,從而產生等離子體。在場的每個循環中,電子在室中上下電加速,有時撞擊室的上壁和晶片盤。同時,響應於RF電場,更大質量的離子移動相對較少。當電子被吸收到腔室壁中時,它們被簡單地送到地面並且不會改變系統的電子狀態。然而,沉積在晶片碟片上的電子由於其DC隔離而導致碟片積聚電荷。這種電荷積聚在碟片上產生大的負電壓,通常約為幾百伏。由於與自由電子相比較高的正離子濃度,等離子體本身產生略微正電荷。由於大的電壓差,正離子傾向於朝向晶片盤漂移,在晶片盤中它們與待蝕刻的樣品碰撞。離子與樣品表面上的材料發生化學反應,但也可以通過轉移一些動能來敲除(濺射)某些材料。由於反應離子的大部分垂直傳遞,反應離子蝕刻可以產生非常各向異性的蝕刻輪廓,這與濕化學蝕刻的典型各向同性輪廓形成對比。RIE系統中的蝕刻條件很大程度上取決於許多工藝參數,例如壓力,氣體流量和RF功率。 RIE的改進版本是深反應離子蝕刻,用於挖掘深部特徵。

反應離子刻蝕操作方法
早期的干法腐蝕為濺射腐蝕和離子銑蝕,利用放電時產生的高能惰性離子(如Ar+離子)對材料進行物理轟擊,實現對材料的腐蝕,因此選擇性差。反應離子腐蝕(Reactive Ion Etching, 簡稱RIE)中反應氣體(如CF4)在RF或直流電場中被激發分解,產生活性粒子(如遊離的F原子),活性粒子與被腐蝕材料反應,生成揮發性物質,再用抽氣泵將揮發性物質排除反應腔室。RIE常用的反應氣體有SF6、CHF3、CCl4等。MEMS應變式結冰感測器腐蝕氮化硅和氧化硅,開濕法腐蝕的窗口,所用反應氣體為SF6,發生的反應如下。
分解反應:電離反應:吸附反應:

SF6的分解反應
SF6腐蝕硅

SF6的電離反應
SF6對硅的腐蝕主要是由SF6分解產生的遊離F基引起的。
(x=0~3)
腐蝕硅產生的揮發性物質揮發將硅帶走,其中其主要作用的是SiF4。氟的等離子體硅腐蝕反應自發進行,不需要離子轟擊。因此自由氟基產生高的腐蝕速率,但由於是自發腐蝕,腐蝕外形近似各向同性(側面腐蝕速率幾乎與垂直速率相等)。
RIE助聽器: